原标题:智造不凡・族领未来 半导体发展的新趋势研讨会暨大族半导体2022年新技术及关键装备发布会隆重召开
半导体照明网消息:5月20日下午,“智造不凡,族领未来”半导体发展的新趋势研讨会暨大族半导体2022年新技术及关键装备发布会在深圳宝安万怡酒店隆重举行。


本次发布会由深圳市大族半导体装备科技有限公司主办,第三代半导体产业技术创新战略联盟和深圳市半导体行业协会支持。配合新冠肺炎疫情防控,发布会采用线上线下结合的方式。其中,深圳市科技创新委员会二级巡视员许建国,季华实验室处长郭汝海,大族激光科技产业集团股份有限公司董事长高云峰,深圳市半导体行业协会荣誉会长周生明,深圳大学微电子研究院、半导体制造研究院院长王序进,第三代半导体产业技术创新战略联盟理事长吴玲,中国半导体行业协会副理事长、国家集成电路封测产业链技术创新战略联盟副理事长兼秘书长于燮康、第三代半导体产业技术创新战略联盟副秘书长赵璐冰、厦门云天半导体科技有限公司董事长于大全,中电化合物半导体有限公司总经理潘尧波,比亚迪半导体股份有限公司陈刚总经理,合肥露笑半导体材料有限公司董事长程明,山东天岳先进科技股份有限公司副总经理窦文涛,株洲中车时代半导体有限公司总工程师刘国友等嘉宾,和来自清华大学、复旦大学、中国电子科技集团公司第五十五研究所、天科合达、国宏中宇、通富微电子、长电集成电路、苏州晶方半导体、绍兴中芯集成等知名院所高校、机构嘉宾和大族半导体众多合作伙伴通过线上线下方式参与了发布会。

会议伊始,深圳市大族半导体装备科技有限公司总经理尹建刚在致辞时首先对与现场及线上参会的嘉宾表示欢迎,他表示,希望借由发布会大家一起探讨半导体行业的发展的新趋势与机会,一起为中国半导体发展多做贡献,把企业做大做强,同时也分享大族半导体近期获得的研究进展成果与突破。

因疫情原因,第三代半导体产业技术创新战略联盟理事长吴玲通过视频方式为发布会致辞,她表示,当前正值新的地理政治学环境下全球半导体竞争力重塑的关键期,第三代半导体也是国家安全、产业链安全的底层技术,特别是支撑我们的祖国“双碳”目标的实现,以及数字化、智能化高水平发展的重要支撑。通过国家863计划,以及 “十三五”、“十四五”等的布局支持,已经解决了很多的技术问题,但是仍然还存在着是否能用、好用的挑战,尤其是在关键材料和核心装备方面,还存在着很大的差距,业内也都非常期盼希望我国第三代半导体真正能做到全链条的自主可控,真正能支撑我们的祖国及人类社会的绿色低碳可持续发展。吴玲理事长对此次研讨会的技术和装备发布表达了期待。

▲ 中国半导体行业协会副理事长、国家集成电路封测产业链技术创新战略联盟副理事长兼秘书长 于燮康
中国半导体行业协会副理事长、国家集成电路封测产业链技术创新战略联盟副理事长兼秘书长于燮康也通过视频为发布会致辞时指出,众多多个方面数据显示,在产业政策等支持下,国产半导体装备发展迅速,在新的时代背景下发展也面临着新的机遇和挑战。大族半导体已经深耕行业多年,也希望有机会能够再接再厉,为国产半导体装备的发展贡献力量。

深圳市半导体行业协会荣誉会长周生明致辞时表示,过去很久里,很多关键材料和装备都是依赖于国外。近些年,随着国内外形势的变化,产业发展在材料与装备面临着巨大的制约与挑战,国内产业要想达到自主可控,更深层次的发展需要把制造发展起来,国产设备是很重要的一环。对于大族半导体这样很早开始布局的设备企业而言是很好的发展机遇,也相信未来大族会持续为国家半导体的发展贡献应有的力量。

深圳市科学技术创新委员会许建国巡视员致辞时表示,近年来面对错综复杂的国内外形势,深圳市委市政府,深入实施创新引领战略,深化科技管理体制机制改革,强化科学技术创新创研能力,不断完善全过程创新生态链,不断增强科学技术创新的牵引力和支撑力,致力于打造具有全球影响力的国际科技和创新高地,大族半导体一直瞄准行业关键技术的研发,不断增强自主创新能力,走出科技企业高质量发展的代表性路径,希望更多像大族这样的优秀企业,建立更多的人才技术和产业的合作,更深层次的加大对深圳相关产业的帮助和支持,共同助力我国半导体行业的发展。

大族激光科技产业集团股份有限公司董事长高云峰高度重视本次会议,他认真聆听诸位嘉宾发言后,高云峰董事长致辞时表示,半导体行业是一个非常典型的交叉性学科,涉及到半导体材料、装备、工艺以及下游的应用,上游的设计等,应用场景非常广泛,对性能要求也非常多元化、多样化。互联网时代企业需要加速科技创新。新型半导体材料与激光技术的结合非常之密切,要突破工艺问题需要多方合作携手攻关。大族激光目前拥有全世界最先进的各种光源,非常希望与大家一起携手合作去研发突破。衷心希望未来能有越来越多的同仁能加入大族激光生态圈,一起携手共同研发更多的特殊工艺及开拓更多细分市场,实现互利共赢。
碳化硅材料具有耐高压、高频率、散热好,能耗低等优势,广泛应用于智能电网,光伏储能,轨道交通,电动汽车,工业机电,数据中心,消费电子等领域,从碳化硅器件制造流程来看,当前碳化硅晶锭切割面临着材料损耗大(200um),效率慢(45min/pcs),大尺寸晶锭加工(8英寸),晶圆切割厚度(450um-500um)等痛点。研讨会期间,大族半导体重磅发布了其激光切片(QCB技术),并隆重推出了其第三代半导体新品设备——SiC晶锭激光切片机HSET-S-LS6200与SiC超薄晶圆激光切片机 HSET-S-LS6210。

大族半导体研发总监巫礼杰详细介绍解析了此次发布的最新技术与最新设备。其中,激光切片(QCB技术)在切口损耗、研磨损耗、薄片切割、单位晶锭、加工效率等方面具有明显优势。SiC晶锭激光切片机HSET-S-LS6200采用了自主开发剥离技术与自主开发材料动态分析单元,晶体支持厚度5cm,晶锭支持加工尺寸最大可达8inch,可支持生产成本降低73%。SiC超薄晶圆激光切片机 HSET-S-LS6210的超薄器件切片技术100um,可支持生产成本降低60%。瞬间成为了全场的焦点。据巫总介绍,以切割2cm厚度的晶锭,分别产出最终厚度350um,175um和100um的晶圆为例,QCB技术可在原来传统线切割的基础上提升分别为40%,120%和270%的产能,这一革命性突破瞬间吸引众多行业内人士的关注。
会上,大族半导体研发总监庄昌辉分享了大族半导体装备国产化的发展现状,报告结合当前半导体行业的产业趋势以及激光装备行业格局,介绍了大族半导体的多方位装备布局,目前大族半导体主要激光产品已经覆盖硅半导体、化合物半导体及泛半导体领域的晶圆制造、前道、封测道的传统封装和先进制程环节。并介绍了大族半导体在表切、激光剥离技术、开槽机、IC激光打标机、晶圆打标机、TGV、刀轮机、光刻机、MiniLED巨量转移及修复、晶圆芯片分选机、AOI等方面的设备及技术工艺进展,在所涉及激光设备领域均实现市占率行业领先。目前LED表切市占率第一,LED隐切领域HSET市占率超过80%。刀轮机方面,获得半导体行业龙头客户订单,12英寸双轴全自动批量验证通过,市占率稳步提升,2022年即将进入国内前三甲。
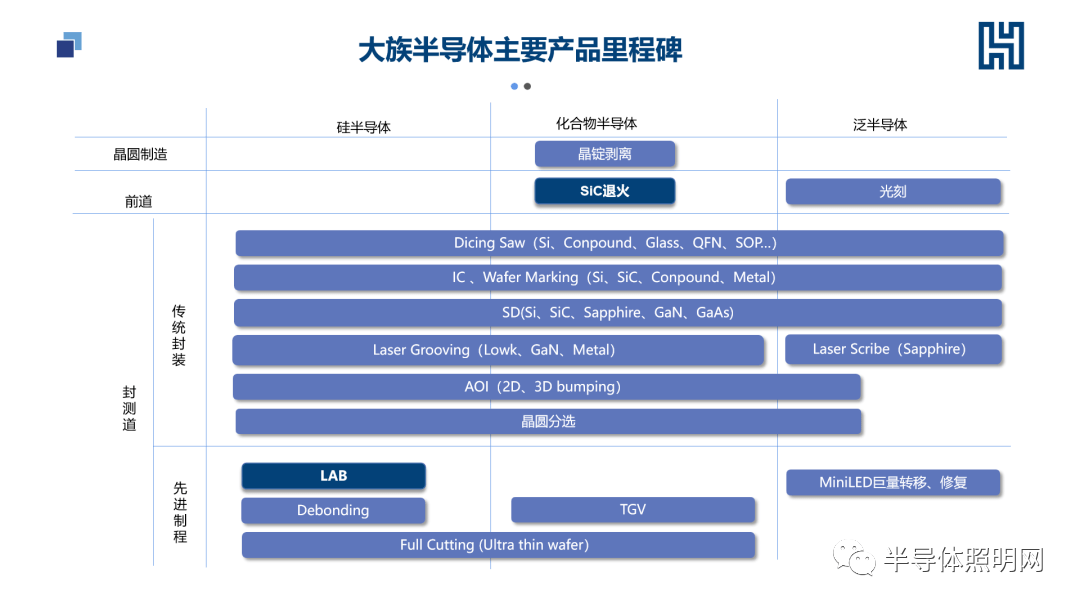
其中,大族半导体2017年推出国产首台激光开槽设备,2018年全球首推超快激光开槽技术,2021年全球首台3D封装制程激光开槽设备。TGV技术方面,2015年全球首台实现飞秒激光ICICLES透明脆性材料加工工艺突破,2019年率先突破TGV工艺,实现设备量产。Laser Grooving+Dicing Saw方面,2020年MP机型GV553面世,实现晶圆开槽设备国产化。2021年GV5232标准款兼容全切功能Full Cutting适应芯片超薄化趋势。2022年GV5242前道晶圆制造开槽机,全球首台,配合晶圆3D封装制程开槽设备,实现LG+plasma工艺。2017年国产首台激光开槽设备,2018年全球首推超快激光开槽技术,2021年全球首台3D封装制程激光开槽设备。自主研发核心多光点高效率切割系统,实现晶圆超薄制程全切功能。2020年实现国产首台SDBG切割工艺设备。Micro-LED巨量转移设备方面,推出国内首台激光巨量转移设备,转移效率10KK/H。刀轮机方面,DL9212-A型刀轮机获得半导体行业龙头客户订单,12英寸双轴全自动已批量验证通过,市占率稳步提升,2022年即将进入国内前三甲。2022年推出首台晶圆芯片分选机,高速总线系统,高校稳定,国产化率高,后期维护,更换零配件快捷。
研讨会分为第三代半导体和半导体封测两个主题报告环节,在第三代半导体主题报告环节中,多位专家带来精彩分享。
当前全球面临“芯片荒”,比如汽车半导体、手机芯片等一片难求,美国、欧盟、日本都加大投入,龙头企业逐渐完备全产业链布局,以提高未来在全球半导体产业的话语权和供应链的控制权。全球第三代半导体仍然由美日欧企业主导,美国等发达国家通过设立国家级创新中心、产业联盟等形式,引领、加速并抢占全球第三代半导体市场。龙头企业不断完善全产业链布局,通过对上下游企业并购和深度合作,提升竞争力,形成产业链整合趋势。

国家重大战略和支撑经济高水平发展对第三代半导体的需求迫切,第三代半导体也支撑国家能源革命,助力“双碳”战略”,支撑高速列车、新能源汽车、5G基站等新型基础设施系统的升级换代,支撑光电子与微电子深度融合,有望实现跨界创新应用引领。第三代半导体产业技术创新战略联盟副秘书长赵璐冰做了题为“第三代半导体产业高质量发展现状及趋势变化分析”的主题报告,结合国际产业高质量发展现状,分享了当前国内产业链,从材料到技术、应用的现状与趋势。当前我国技术实力提升,市场快速启动,产业链初步形成。应用需求驱动产业链各环节加快速度进行发展,功率电子支撑国家“双碳”战略,亟待缩小与国际差距等。报告说明,核心装备国产化面临着超高温、高硬度、高工艺等挑战,但也迎来了战略机遇期,国家层面,”十四五“国家科技计划统筹规划,形成发展合力,争取未来十年全链条进入世界先进行列。联盟也希望与行业企业一起努力,共同建立协同创新的产业体系和生态。

来自国内“碳化硅第一股”、国内领先的第三代半导体衬底材料生产商—山东天岳先进科技股份有限公司先进研究院梁庆瑞院长详细分享了“大尺寸碳化硅单晶加工工艺及产业化”,结合当前碳化硅半导体的主要应用方向,碳化硅基氮化镓及碳化硅电力电子行业全球产业供应链,产能分布预测等发展的新趋势,分享了晶锭加工,晶棒切割,化学机械抛光,清洗等内容。他表示,碳化硅是一种典型的硬脆材料,硬度仅次于金刚石,且物理化学性质很稳定,但是碳化硅晶体硬度高,磨削难度大,过程中容易碎裂。PVT生长方法晶体内应力大,会造成衬底的弯曲度/翘曲度难以控制。过程中需要用金刚石制品来提高去除率,但是加工损伤层难以去除。抛光过程去除效率低,且易产生划伤。碳化硅衬底表面为亲水性,容易吸附颗粒和金属离子。小英寸向6英寸/8英寸发展,但衬底最终厚度规格低于500um,加工控制难度指数增加。在晶棒切割过程中,传统方式选用砂浆多线切割,优势是表面上的质量高,但是效率低,线损高,且易段线导致裂片,大尺寸切削力不足,难以切割薄片,难以实现全自动化。未来方向就是采取了激光剥离技术,采用大族半导体装备实践,采取了激光剥离技术无线倍,并且大尺寸剥离同样适用,可剥离薄片,有机会实现全自动化。

南方科技大学副教授叶怀宇介绍了碳化硅芯片及模块最新进展,第三代半导体碳化硅具备带宽度、大漂移速率、大导热率、大击穿场强等优势,从而能开发出更适应高功率、高频、高温、高电压等恶劣条件的功率半导体器件,总的来看,碳化硅的耐高压能力是硅的10倍,耐高温能力是硅的2倍,高频能力是硅的2倍。与硅基模块相比,碳化硅二极管及MOS管组成的模块,不仅仅具备碳化硅材料本征特性优势,在应用时还可以缩小模块体积50%以上,消减电子转换损耗80%以上,以此来降低综合成本。碳化硅功率器件主要使用在于白色家电,新能源汽车,工业应用等领域,应用愈发广泛。报告分享了国内碳化硅芯片技术进展,以及封装设计及结构、封装材料、封装工艺及设备等的最新进展,以及碳化硅MOS器件技术路线(新能源),碳化硅器件全铜互连技术等内容。报告说明,碳化硅器件在理论应用模型、芯片制造工艺、器件封装技术、试验标准与评价方法等还存在一些核心问题,需要行业共同努力解决。

在研讨会的半导体封测主题专场部分,深圳大学微电子研究院、半导体制造研究院院长王序进院士带来了“集成电路产业高质量发展回顾与展望”的主题报告,结合国际半导体近几十年的历史变迁与发展,分享了摩尔定律/芯片制造工艺节点推进与展望。

厦门云天半导体科技有限公司董事长于大全做了题为“新时代先进封装发展的新趋势和对国产装备的期待”的主题报告,他表示,当前物联网、移动通讯、5G、电动车、大数据等应用的发展驱动着封装技术持续不断的发展,先进封装主要技术平台中大部分和晶圆级封装技术相关,先进封装技术本身不停地改进革新发展,以应对更为复杂的三维集成需求。当前,高密度TSV技术/Fan-Out扇出技术由于其灵活、高密度,适于系统集成,而成为目前先进封装的核心技术。报告分享了TSV、SoIC技术,以及扇出封装技术发展与应用、扇出型封装典型工艺、InFO技术、面板级扇出封装等,报告说明,传统封装主流设备卡脖子之处在于减薄机、12吋划片机等,而先进封装落后装备在于电镀机、圆片键合机、面板级封装设备、检测设备等。同时分享了企业协同创新的玻璃通孔(TGV)三维集成技术与射频器件晶圆级三维封装技术。

最后,由来自国内领先的券商股权直司--中信证券投资有限公司先进制造业负责人高妍在线分享了“半导体投资现状及机遇”主题报告。报告中指出,当前全球半导体市场规模正稳步上升,据WSTS预测,需求旺盛带动2021年全球半导体营收创历史记录至5510亿美元,增速达多年新高,2022年也将维持不菲的增速。她认为,当前全球半导体产业呈现高度专业化分工和高度集中的特点,我国半导体市场规模持续稳定增长,其中设计环节成长较快。中国大陆自从2020年起成为全世界最大、增速最快的半导体装备市场。受芯片短缺及半导体产业链重构的影响,全球晶圆厂新建及扩产仍处于上升周期。全球扩产,设备先行,全球半导体装备处于高景气周期,中国市场增长迅猛。2020年开始,半导体投资热度迅速提升,投资相中后期推移。从细分行业来看,设计、材料设备领域投资热度增加最快速。尤其是科创板为半导体公司上市打开通道,进一步助推了半导体一级市场投资热情。当前,半导体产能逐步向中国大陆转移,美国全面打压中国半导体发展,我国半导体供应长期依赖于国际循环,高端芯片存在制造短板和供应风险等因素,但从我国半导体行业的外部环境和局面出发,国产替代仍然是长期投资逻辑。并且,半导体全产业链均有巨大的替代空间,核心环节如EDA、核心装备替代空间达十数倍。


